5.9: Транспровідність
- Page ID
- 31751
Польовий транзистор - це джерело струму, кероване напругою. Його вхід - потенціал затвора, а на виході - струм джерела-стоку. У додатках ми зазвичай хочемо, щоб FET посилював невеликі зміни в\(V_{GS}\). Таким чином, важливою фігурою заслуг для транзистора є транспровідність, визначена як
\[ g_{m} = \frac{dI_{ds}}{dV_{gs}} \nonumber \]
У вимкненому стані квантова ємність мала, і лише вплив воріт на транзисторний транзистор - це його електростатичний контроль потенціалу каналу. З Рівняння (5.3.1) ми бачимо, що цей контроль максимізується, коли
\[ C_{G} \gg C_{S},C_{D} \nonumber \]
Це важлива мета проектування для транзисторів. Під цією межею транспровідність зазвичай виражається у вигляді:
\[ \frac{g_{m}}{I_{ds}} = \frac{1}{I_{ds}}\frac{dI_{ds}}{dV_{gs}} = \frac{q}{kT} \nonumber \]
Хороший електростатичний контроль каналу може бути досягнутий або збільшенням діелектричної проникності ізолятора затвора, або зменшенням товщини ізолятора затвора.
Хорошим емпіричним правилом є те, що затвор повинен знаходитися набагато ближче до каналу, ніж або контакти джерела, або зливу. Малюнок 5.9.1 показує вплив зміни\(C_{G}\) на наш молекулярний транзистор C60. \(C_{G}\)Збільшення зміщує напругу комутаційного затвора набагато нижче.
Цікаво, що для отримання цієї ідеальної характеристики ми\(C_{G}\) збільшили на три порядки щодо більш практичного значення, використовуваного спочатку. Це відповідає збільшенню діелектричної проникності або зменшенню поділу затвор-канал на три порядки.
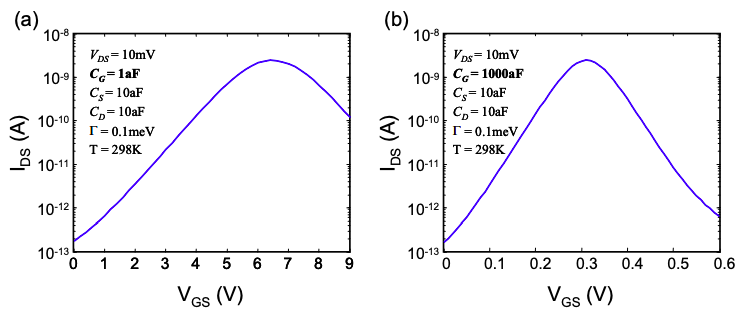
Для молекулярного транзистора з розділенням джерела-стоку на кілька нанометрів, ізолятор затвора повинен бути лише кілька Ångstroms — занадто тонкий, щоб достатньо ізолювати затвор. Це є можливо непереборною перешкодою для 0-d канальних пристроїв, таких як одиночні молекули FET.
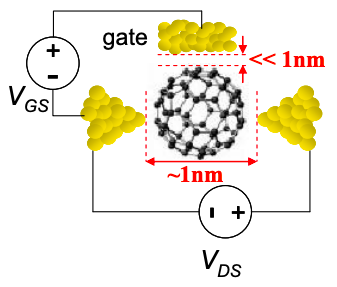
1d і 2d транзистори
Центральне рівняння провідності
\[ I=\frac{q(N_{S}-N_{D})}{\tau} \nonumber \]
У 0-d постійна часу\(\tau\), була визначена як сума часу міжфазного перенесення електронів\(\tau_{S}\) і\(\tau_{D}\), яка, в свою чергу, може розглядатися як уявлення про енергію взаємодії між 0-d провідником і контактами джерела і стоку:\(\tau_{S}=\Gamma_{S}/\hbar\) і\(\tau_{D}=\Gamma_{D}/\hbar\), відповідно.
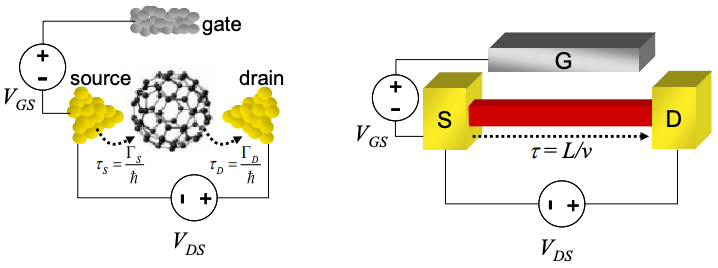
Однак у більш високих розмірах час перенесення електронів на контактах менш важливий. Швидше,\(\tau\) це час транзиту електрона в провіднику. Це дається
\[ \tau=\frac{L_{x}}{v_{x}} \nonumber \]
де\(L_{x}\) - довжина каналу, і\(v_{x}\) - швидкісна складова електрона паралельно струму джерело-стік. Важливо відзначити, що в 1-d, 2-d і 3-d провідниках час проходження залежить від енергії електрона, оскільки швидкість електронів\(v_{x}\), залежить від енергії.
Інша важлива зміна від 0-d моделі стосується щільності станів. У 0-d всі стани доступні електронам як з контактів джерела, так і стоку. Але в балістичних пристроях вищих розмірів електрони, що вводяться з джерела, здатні отримувати доступ лише до станів з моментами, спрямованими подалі від джерела. Ми називаємо ці стани +k. Аналогічно, стік лише впорскує електрони в —k стани. Таким чином, ми розбиваємо співвідношення дисперсії та щільність станів на дві частини, задана щільність станів +k\(g^{+}(E)dE\) і задана щільність станів —k\(g^{-}(E)dE\).
Підводячи підсумок, в 1-d, 2-d і 3-d фундаментальні рівняння для транзистора такі:
\[ U_{ES} = -qV_{GS}\frac{C_{G}}{C_{ES}}-qV_{DS}\frac{C_{D}}{C_{ES}}+\frac{q^{2}}{C_{ES}}(N-N_{0}) \nonumber \]
\[ N=N_{S}+N_{D} \nonumber \]
\[ I=\frac{q}{\tau}(N_{S}-N_{D}) \nonumber \]
де
\[ N_{S} = \int^{\infty}_{-\infty} g^{+}(E-U)f(E, \mu_{S})dE \nonumber \]
\[ N_{D} = \int^{+\infty}_{-\infty} g^{-}(E-U)f(E, \mu_{D})dE \nonumber \]
