3.2: Основна структура МОП
- Page ID
- 34479
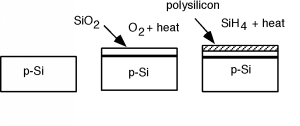
\(\PageIndex{1}\)На малюнку показані кроки, необхідні для виготовлення конструкції МОП. Це допоможе нам у нашому розумінні, якщо ми зараз повернемо нашу картинку так, щоб вона була спрямована вбік на наших наступних кількох малюнках. (Крім того, ми забудемо про дві n-області на деякий час, і заберемо їх назад пізніше, коли ми знову повернемо структуру правою стороною вгору.) На малюнку\(\PageIndex{2}\) показана повернута конструкція. Відзначимо, що в р-кремнію у нас позитивно заряджені рухливі отвори, і негативно заряджені, нерухомі акцептори. Оскільки нам це знадобиться пізніше, ми також показали діаграму діапазону для напівпровідника під ескізом пристрою. Зверніть увагу, що оскільки субстрат p-типу, рівень Фермі розташований вниз близько до смуги прокладання.

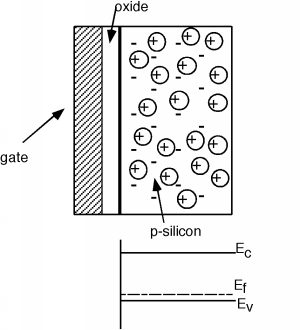
Малюнок\(\PageIndex{2}\): Базова структура MOS
Давайте тепер розмістимо потенціал між затвором і кремнієвою підкладкою. Припустимо, ми робимо воріт негативним по відношенню до підкладки. Так як підкладка p-типу, в ній багато рухливих, позитивно заряджених отворів. Деякі з них будуть притягуватися до негативного заряду на затворі, і переходити на поверхню підкладки. Це також відображено на діаграмі смуг під ескізом конструкції на рис\(\PageIndex{3}\). Пам'ятайте, що щільність отворів експоненціально пропорційна тому, наскільки близький рівень Фермі до краю валентної зони. Ми бачимо, що діаграма смуги була зігнута трохи біля поверхні, щоб відобразити зайві отвори, які там накопичилися.

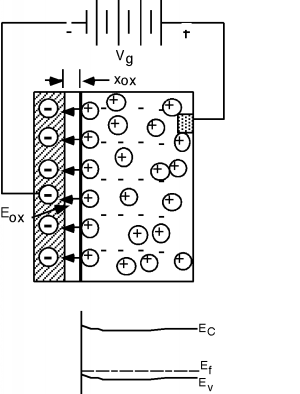
Малюнок\(\PageIndex{3}\): Застосування негативної напруги затвора
Між позитивними отворами і негативним зарядом затвора буде розвиватися електричне поле. Зверніть увагу, що затвор і підкладка утворюють своєрідний паралельний пластинчастий конденсатор, причому оксид виступає в ролі ізоляційного шару між ними. Оксид досить тонкий в порівнянні з площею приладу, і тому цілком доречно припустити, що електричне поле всередині оксиду однорідне. (Ми будемо ігнорувати окантовку по краях.) Інтегралом електричного поля є якраз прикладене напруга затвора\(V_{g}\). Якщо оксид має товщину\(x_{\text{ox}}\),\(E_{\text{ox}}\) то так як однорідна, то вона дається\[E_{\text{ox}} = \frac{V_{g}}{x_{\text{ox}}}\]
Якщо ми зосередимось на невеликій частині воріт, ми можемо зробити невелику коробку «таблетки», яка простягається звідкись в оксиді, через інтерфейс оксиду/ворота і закінчується всередині матеріалу воріт десь. Коробка для таблеток матиме площу\(\Delta (s)\). Тепер будемо посилатися на закон Гаусса, який ми розглянули раніше. Закон Гаусса просто говорить, що поверхневий інтеграл над замкнутою поверхнею вектора зміщення\(D\) (який, звичайно, просто\(\varepsilon\) раз\(E\)) дорівнює загальному заряду, укладеному цією поверхнею. Будемо вважати, що на поверхні електрода затвора є поверхнева щільність заряду\(-Q_{g}\), в одиницях (рис\(\PageIndex{4}\).\(\frac{\mathrm{Coulombs}}{\mathrm{cm}^2}\) Невід'ємною формою Закону Гаусса є якраз:\[\oint \varepsilon_{\text{ox}} \mathbf{E} \ d \mathbf{S} = Q_{\text{encl}}\]

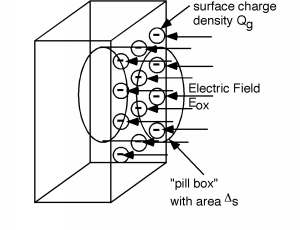
Малюнок\(\PageIndex{4}\): Знаходження поверхневої щільності заряду
Зверніть увагу, що ми використовували\(\varepsilon_{\text{ox}} E\) замість\(D\). У цій конкретній установці інтеграл легко виконати, так як електричне поле рівномірне, і лише спрямоване через одну поверхню — воно закінчується на негативному поверхневому заряді всередині коробки таблеток. Заряд, укладений у коробку для таблеток\(Q_{g} \Delta (s)\), справедливий, і тому ми маємо (маючи на увазі, що поверхневий інтеграл вектора, що вказує на поверхню, негативний)\[\begin{array}{l} \oint \varepsilon_{\text{ox}} \mathbf{E} \ d \mathbf{S} &= -\left( \varepsilon_{\text{ox}} E_{\text{ox}} \Delta (s)\right) \\ &= - \left(Q_{g} \Delta (s)\right) \end{array}\]
або\[\varepsilon_{\text{ox}} E_{\text{ox}} = Q_{g}\]
Тепер ми можемо використовувати рівняння\(\PageIndex{1}\), щоб отримати\[\frac{\varepsilon_{\text{ox}} V_{g}}{x_{\text{ox}}} = Q_{g}\]
або\[\frac{Q_{g}}{V_{g}} = \frac{\varepsilon_{\text{ox}}}{x_{\text{ox}}} \equiv c_{\text{ox}}\]
Величина\(c_{\text{ox}}\) називається оксидною ємністю. Він має одиниці виміру\(\frac{\mathrm{Farads}}{\mathrm{cm}^2}\), тому це дійсно ємність на одиницю площі оксиду. Діелектрична проникність діоксиду кремнію\(\varepsilon_{\text{ox}}\), становить близько\(3.3 \times 10^{-13} \mathrm{~F} / \mathrm{cm}\). Типова товщина оксиду може бути\(250 \AA\), або\(2.5 \times 10^{-6} \mathrm{~cm}\). У цьому випадку\(c_{\text{ox}}\) буде приблизно\(1.30 \times 10^{-7} \ \frac{\mathrm{F}}{\mathrm{cm}^2}\). (Одиниці, які ми використовуємо тут, хоча вони можуть здатися трохи довільними і заплутаними, є найбільш часто використовуваними в напівпровідниковому бізнесі. Ви звикнете до них через короткий час.)
Найбільш корисною формою рівняння\(\PageIndex{6}\) є те, що воно обертається:\[Q_{g} = c_{\text{ox}} V_{g}\]
оскільки це дає нам можливість знайти заряд на воротах з точки зору потенціалу воріт. Ми будемо використовувати це рівняння пізніше в нашій розробці того, як насправді працює МОП-транзистор.
Виявляється, ми не зробили нічого дуже корисного, подавши на затвор негативну напругу. Ми намалювали більше отворів там у тому, що називається шаром накопичення, але це не допомагає нам у наших спробах створити шар електронів у MOSFET, який міг би електрично з'єднати дві n-області разом.
Давайте розвернемо батарею і подаємо позитивну напругу на затвор. (Насправді, давайте зараз виймемо батарею з ескізу, і просто нехай\(V_{g}\) буде позитивне значення, щодо основи, яка буде прив'язана до землі.) \(V_{g}\)Внесення позитиву ставить позитив\(Q_{g}\) на ворота. Позитивний заряд відштовхує отвори від області під затвором і розкриває частину негативно заряджених нерухомих акцепторів. Тепер електричне поле вказує в іншу сторону і йде від позитивного заряду затвора, закінчуючись на негативному акцепторному заряді всередині кремнію.
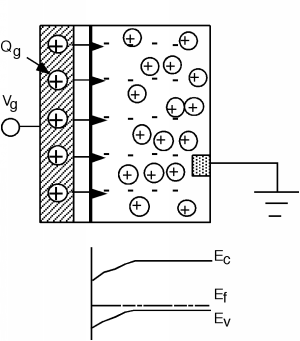
Електричне поле тепер поширюється в напівпровідник. З нашого досвіду роботи з p-n переходом ми знаємо, що при наявності електричного поля відбувається зсув потенціалу, який представлений на діаграмі смуг згинанням смуг. Згинання смуг вниз (як ми повинні рухатися до позитивного заряду) призводить до того, що валентна зона відходить від рівня Фермі біля поверхні напівпровідника. Якщо ви пам'ятаєте вираз, який ми мали для щільності дірок з точки зору\(E_{v}\) і\(E_{f}\) (рівняння щільності електронів та дірок), то легко помітити, що насправді\[p = N_{v} e^{- \frac{E_{f} - E_{v}}{kT}} \]
поблизу регіону під воротами є область виснаження (область, в якій майже немає отворів). (Після того, як\(E_{f} - E_{v}\) стає великим по відношенню до\(kT\), негативний показник причини\(p \rightarrow 0\).
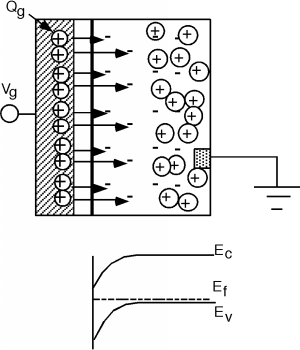
Електричне поле поширюється далі в напівпровідник, так як більше негативного заряду розкривається і смуги згинаються далі вниз. Але тепер ми повинні згадати рівняння електронної густини, яке говорить нам, скільки електронів у нас є:\[n = N_{c} e^{- \frac{E_{c} - E_{f}}{kT}}\]
Погляд на рисунок\(\PageIndex{6}\) вище показує\(E_{c}\), що при такому згинанні смуги краю провідності та\(E_{f}\) рівень Фермі починають наближатися один до одного (принаймні порівняно з\(kT\)), що означає\(n\), що концентрація електронів незабаром повинна стати значний. У ситуації, представленої малюнком\(\PageIndex{6}\), ми говоримо, що ми знаходимося на порозі, а напруга затвора в цій точці називається пороговим напругою,\(V_{T}\).
Тепер давайте збільшимо\(V_{g}\) вище\(V_{T}\). Ось ескіз на малюнку\(\PageIndex{7}\).

Незважаючи на те, що ми збільшилися\(V_{g}\) понад порогове напруга\(V_{T}\), і на затворі з'являється більше позитивного заряду, область виснаження більше не рухається назад в підкладку. Замість цього електрони починають з'являтися під областю воріт, а додаткові лінії електричного поля закінчуються на цих нових електроах замість додаткових акцепторів. Ми створили інверсійний шар електронів під воротами, і саме цей шар електронів ми можемо використовувати для з'єднання двох областей n-типу в нашому початковому пристрої.
Звідки взялися ці електрони? У нас немає ніяких донорів в цьому матеріалі, тому вони звідти не можуть прийти. Єдине місце, з якого можна було б знайти електрони, було б через теплову генерацію. Пам'ятайте, що в напівпровіднику завжди є кілька пар електронних дірок, що генеруються тепловим збудженням в будь-який момент часу. Електрони, які створюються в області виснаження, вловлюються електричним полем і змітаються до краю воротами. Я спробував запропонувати це за допомогою події генерації електронів, показаної на діаграмі смуги на малюнку. У реальному MOS пристрої ми маємо дві n-області, і електрони з одного або обох легко «потрапляють» в потенційну яму під затвором і створюють інверсійний шар електронів.