4.6: Фотолітографія
- Page ID
- 34555
Насправді імплантати (особливо для ровів) зазвичай робляться з досить високою енергією, так що дофант (фосфор) вже досить далеко знаходиться в субстраті (часто кілька мікрон або близько того), ще до початку дифузії. Відпал/дифузія трохи більше переміщує домішки у пластину, і, як ми побачимо, також робить n-область збільшуватися.
«N-регіон»! Ми нічого не сказали про те, як ми робимо свій рів лише в певних областях вафлі. З опису, який ми маємо до цих пір, здається, ми просто побудували шар n-типу по всій поверхні пластини. Це було б погано! Нам потрібно придумати якесь «вікно», щоб дозволити імплантуючим домішкам потрапляти в кремнієву пластину там, де ми хочемо їх, а не в іншому місці. Ми зробимо це шляхом побудови імплантаційного «бар'єру».
Для цього перше, що ми робимо, це нарощуємо шар діоксиду кремнію по всій поверхні пластини. Ми говорили про зростання оксидів, коли ми обговорювали МОП-транзистори, але давайте перейдемо трохи докладніше. Ви можете вирощувати оксид або в сухій атмосфері кисню, або в атмосфері, яка містить водяну пару або пар. На малюнку\(\PageIndex{1}\) ми показуємо товщину оксиду як функцію часу для росту з парою. Сухий поводиться\(O_{2}\) не надто по-різному; швидкість просто дещо повільніше.

Малюнок\(\PageIndex{1}\): Товщина оксиду як функція часу

На вершині оксиду ми зараз збираємося внести ще один матеріал. Це нітрид кремнію\(\mathrm{Si}_{3} \mathrm{N}_{4}\), який зазвичай називають просто «нітридом». Нітрид кремнію осаджується за допомогою методу, який називається хімічним осадженням пари або «CVD». Звичайна техніка полягає у реакції дихлорсилану та аміаку в гарячій стінній системі хімічного осадження пари низького тиску (LPCVD). Реакція така:\[3 \left(\mathrm{Si}, \mathrm{H}_{2}, \mathrm{Cl}_{2}\right) + 10 \left(\mathrm{N}, \mathrm{H}_{3}\right) \rightarrow \mathrm{Si}_{3} \left(\mathrm{N}_{4}\right) + 6 \left(\mathrm{N}, \mathrm{H}_{4}, \mathrm{Cl}\right) + 6 \left(\mathrm{H}_{2}\right)\]
Нітрид кремнію є хорошим бар'єром для домішок, кисню та інших речей, які ми не хочемо потрапляти у пластину. Погляньте на Малюнок\(\PageIndex{2}\) і подивіться, що ми маємо до цих пір. Слово про масштаб і розміри. Кремнієва пластина приблизно\(250 \ \mu\mathrm{m}\) товста (близько 0,01 «), оскільки вона повинна бути достатньо міцною, щоб не зламатися, як вона обробляється. Два нанесені шари є приблизно\(1 \ \mu\mathrm{m}\) товстими, тому їх насправді слід малювати як лінії тонші, ніж інші лінії на малюнку. Це, очевидно, зробить всю ідею ескізу смішною, тому ми залишимо речі спотвореними, як вони є, маючи на увазі, що відкладені та розсіяні шари насправді набагато тонші, ніж решта пластини, яка насправді нічого не робить, крім підтримки активних схем зверху. (Туди йдемо знову, витрачаючи кремній. Добре, що це дешево і рясно!)

Малюнок\(\PageIndex{2}\): Початкова конфігурація пластини

Тепер те, що ми хочемо зробити, це видалити частину нітриду, так що ми можемо зробити нашу n-ну, але не покласти в фосфор там, де не хочуть цього. Ми робимо це за допомогою процесів, званих фотолітографією та травленням відповідно. Перше, що ми робимо, це покриваємо вафлю ще одним шаром матеріалу. Це рідина, яка називається фоторезистом, і вона наноситься за допомогою процесу, званого спін-покриттям. Вафлю надягають на вакуумний патрон, а поверх пластини розпилюють шар рідкого фоторезиста. Потім патрон швидко обертається, добираючись до декількох тисяч оборотів в хвилину за невелику частку секунди. Відцентрова сила змушує опір рівномірно розтікатися по поверхні пластини (велика його частина, власне, злітає!). Розчинник для фоторезиста досить летючий, і тому шар фоторезиста висихає, поки вафля все ще крутиться, в результаті чого утворюється тонке рівномірне покриття поперек пластини, як показано на малюнку\(\PageIndex{3}\).

Малюнок\(\PageIndex{3}\): Фоторезист закручується

Назва «фоторезист» дає деяку підказку про те, що це за матеріал. В основному фоторезист - це полімер, змішаний з якимось світлосенсибилизирующим з'єднанням. У позитивного фоторезиста всюди, де світло потрапляє на нього, полімер послаблюється, і його легше видалити розчинником в процесі розробки. І навпаки, негативний фоторезист посилюється при освітленні світлом, і більш стійкий до розчинника, ніж неосвітлений фоторезист. Позитивний опір так називається тому, що зображення розробленого фоторезиста на пластині виглядає так само, як маска, яка використовувалася для його створення. Негативний фоторезист створює зображення, протилежне тому, як виглядає маска.
Доводиться придумати якийсь спосіб вибіркового освітлення певних ділянок фоторезиста. Кожен, хто коли-небудь бачив проектор, знає, як ми можемо це зробити. Але, оскільки ми хочемо робити дрібні речі, а не великі, ми змінимо навколо нашого проектора, щоб він зробив менше зображення, а не більше. Прилад, який проектує світло на фоторезист на пластині, називається проекційним принтером або степпером (рис.\(\PageIndex{4}\)).
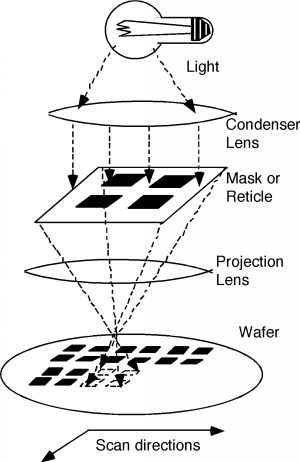
Малюнок\(\PageIndex{4}\): Конфігурація крокової

Як показано на малюнку\(\PageIndex{4}\), степпер складається з декількох частин. Є джерело світла (зазвичай це ртутна лампа, хоча ультрафіолетові ексимерні лазери також починають надходити в експлуатацію), і конденсаторна лінза для зображення джерела світла на масці або сітці. Маска містить зображення візерунка, який ми намагаємося розмістити на вафлі. Потім проекційна лінза робить зменшене (зазвичай на 5 разів) зображення маски на пластині. Тому що було б занадто дорого, якщо не просто неможливо, проектувати на всю пластину відразу, лише невелика вибрана область друкується одночасно. Потім вафлю сканують або переходять в нове положення, і зображення друкується знову. Якщо попередні шаблони вже сформовані на пластині, для вирівнювання поточного зображення з раніше сформованими ознаками використовуються телевізійні камери з алгоритмами штучного інтелекту. Степпер переміщує всю поверхню вафлі під лінзу, поки вафля повністю не покриється потрібним малюнком. Степпер коштує недешево. Зазвичай TI або Intel розщеплюються на кілька мільйонів доларів за кожен! Однак це одна з найважливіших одиниць обладнання у всій фабриці IC, оскільки вона визначає, яким буде мінімальний розмір функції на схемі.
Після впливу фоторезист поміщають у відповідний розчинник, і «розробляють». Припустимо для нашого прикладу, що структура, показана на малюнку,\(\PageIndex{5}\) є результатом фотолітографічного кроку.

Малюнок\(\PageIndex{5}\): Після PR Expose/Розвивати

Візерунок, який використовувався на етапі фотолітографії (PL), піддавав світлу половину нашої області, і тому фоторезист (PR) у цьому регіоні був видалений при розробці. Вафлю тепер занурюють в розчин плавикової кислоти (HF). HF кислота травлює нітрид кремнію досить швидко, але не травить діоксид кремнію майже так швидко, тому після травлення ми маємо те, що ми бачимо на малюнку\(\PageIndex{6}\).

Малюнок\(\PageIndex{6}\): Після травлення нітридом

Тепер беремо нашу вафлю, поміщаємо її в іонний імплантатор і піддаємо «вибуху» іонів фосфору (див. Рис.\(\PageIndex{7}\)).
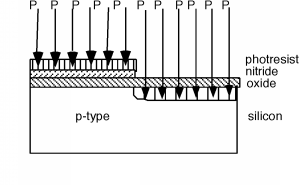
Малюнок\(\PageIndex{7}\): Імплантація фосфору

Іони проходять прямо через оксидний шар з правого боку, але вклеюються в шар фоторезиста/нітриду на лівій половині нашої структури.